- Products
- 製品
- TOP / 製品

半導体解析対応 ViewTool(KAI解析システム)のライセンス販売開始
KAI解析システム
半導体デバイスの大規模テストデータを高速に解析し、品質向上、異常検出、歩留まり改善を支援
主な特徴
高速
大量データでも実用速度で処理。
拡張性
モジュール追加・機能追加が容易。
セキュア
ライセンス管理 / 認証 / アクセス制御に対応。
システム構成
KAI解析システムはKAI ServerとKAI Analysis Toolから構成されています。
KAI Serverは、主にテスタからのテストデータを逐次受信し内部データベースに登録していきます。
KAI Serverでは、データを解析し、テスタの測定異常・不具合、製品の特性異常、装置の異常の早期検知などを行います。
KAI Analysis Toolは、KAI Serverのデータベースに接続し、様々なテストデータ分析を実施します。

使用例

製品・ライセンス取得についてはこちら
製品ページへ ↗KAI解析システム詳細説明
KAI_Analysis_Tool_Client は PC 上で動作するテストデータの解析、分析を行うツールです。 このツールの目的はテストデータを解析、分析することで、以下を実現することです。
- 製品品質の向上
- 歩留まり向上
- 製造異常の早期検知
- 製造、テストコスト削減

導入形態
KAI_Analysis_Tool_Client は、KAI_Analysis_Server_System と一体で運用します。 KAI Analysis Server はテスタ群や上位システムに接続し、テストデータやメタ情報データを受け取り、 内部データベースに書き込みます。KAI_Analysis_Tool_Client は KAI_Analysis_Server のデータベースから データを読み出し、種々の解析、分析を行います。
KAI_Analysis_Tool_Client は KAI_Analysis_Server のデータベースに接続することで 多量のデータを取り扱うことが可能となりますが、データベースにアクセスすることなく 単独でテストデータファイル(stdf など)を読み込んで解析を実施することも可能です。 ただし、その場合、状態遷移解析のようにデータを時系列で分析したり、 多量のデータから何らかの特徴を見出す分析の実施は困難になります。
1基本的統計解析
テストデータをロット単位、Wafer 単位で各パラメトリックデータの分布状況や、 Wafer 面内分布(heat map)、統計量の算出、データの加工などを実施します。
また、テストデータの分布状況から外れ値検出、不良候補といった分析も可能です。

2相関解析
パラメトリックテストデータ間の相関を分析します。 また相関から外れたデータ(デバイス/チップ)を外れ値として検出し、不良候補として分類することもできます。 相関は同一 Wafer 内のデータ同士(工程を跨いでもよい)のみならず、 Wafer 間、異 Lot 間など、解析・分析用途として種々の解析が可能です。

3各種 view
Wafer マップ(heat map)、Pass/Fail マップ、Histogram、QQ-Plot、Category マップの表示、一覧表示が可能で、 何らかの異常が発生した場合、直ちに気づくことが容易です。
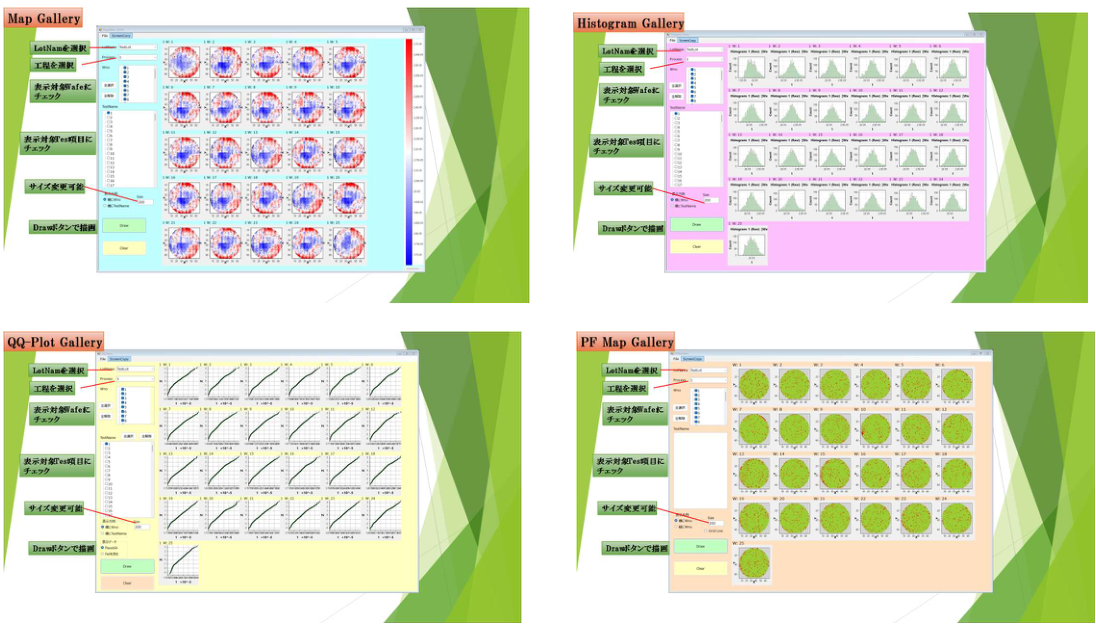
4管理図
統計値、パラメトリックデータの Xbar-R/S 管理図で異常検出可能です。 EWMA 解析、CUSUM 解析も実施できます。

5領域分割管理図
Wafer 領域を分割して(10 分割 / 16 分割)、それぞれの領域ごとに統計値を算出。 これらを管理図で解析することで、異常を早期に検出することができます。
領域の分割方法は 4 通り、対象データは良品率、不良カテゴリ率、 パラメトリックデータの統計値(平均値、中央値、IQR、SD 等)です。


表示例
領域分割マップ、PFマップ、カテゴリマップ、数値マップの表示例です。

製品・ライセンス取得についてはこちら
製品ページへ ↗
